集成电路失效分析报告:AT24C04C-SSHM-T检测
日期:2021-08-18 17:18:15 浏览量:12077 作者:创芯在线检测中心
产品名称:集成电路
产品型号:AT24C04C-SSHM-T
收样日期:2021.07.28
分析时间:2021.07.28-2021.07.31
样品数量编号:不良物料 2 片编号 F1,F2 未上机样品 1 片编号 G1
分析项目:外观检查、电特性分析、X-ray 检查
分析环境条件:常温 25±5ºC,湿度 40%~65% RH
分析依据:GJB548B-2005 微电子器件实验方法和程序 方法 5003

结论:由于外观和 X-ray 检查结果均发现与 G1 样品不同的丝印规则与封装设计,因此根据应 用端描述与综上测试结果分析认为器件整机测试不良可能是由于不同厂商设计的器件驱 动能力不同造成。
A.失效分析步骤
1 失效现象描述:
芯片整机测试不良,不良率 0.5%,2 片。
2 分析过程:
2.1 外观检查:
外观检查发现 F1 和 F2 失效样品均不符合 AMTEL 厂商丝印规则,对所有样品观察均未发现破损、断 脚等异常现象。
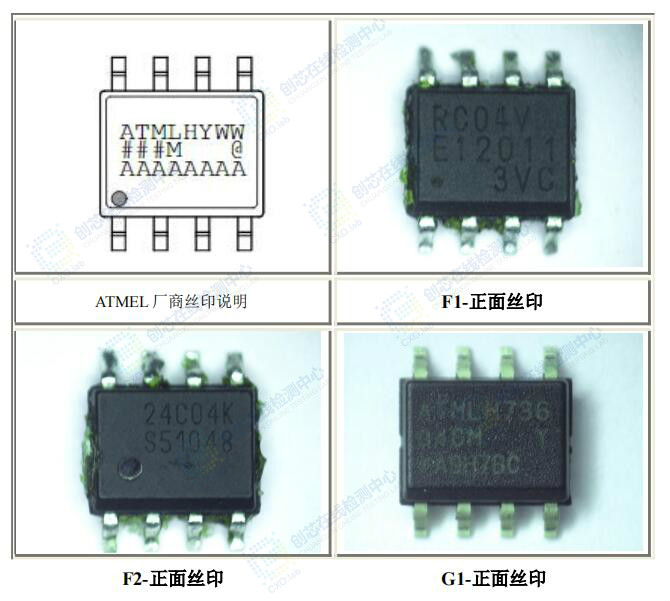
2.2、电特性分析:



2.3、X-ray 检查: 对 F1,F2 与 G1 样品对比测试,结果如下: 框架结构不同的样品:F1,F2&G1 Die 不同的样品:F1&F2, F1&G1, F2&G1 键合线材质疑似不同的样品:F1,F2&G1
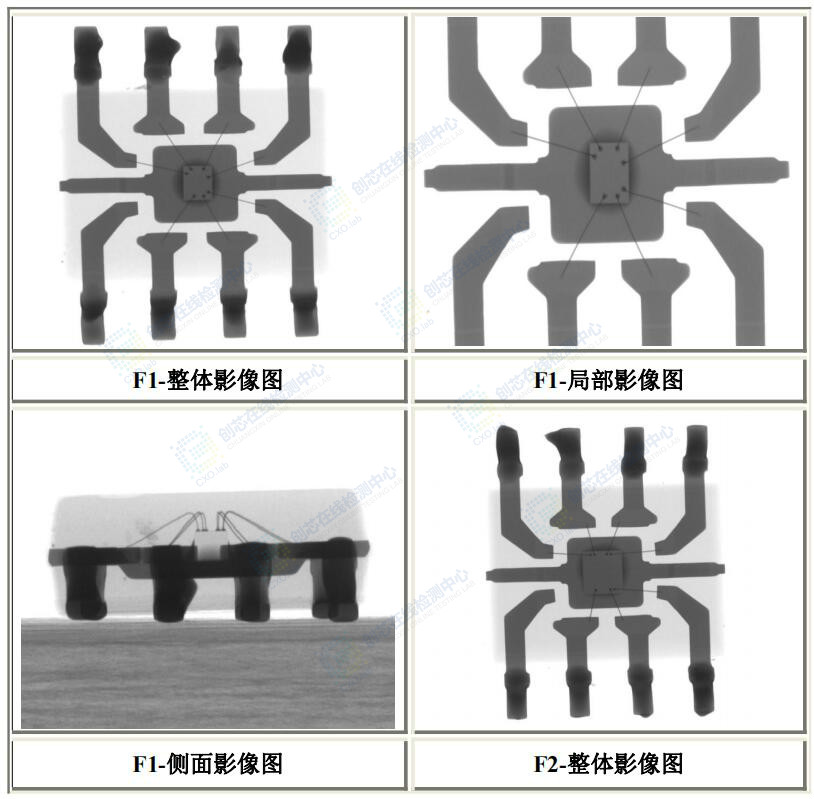
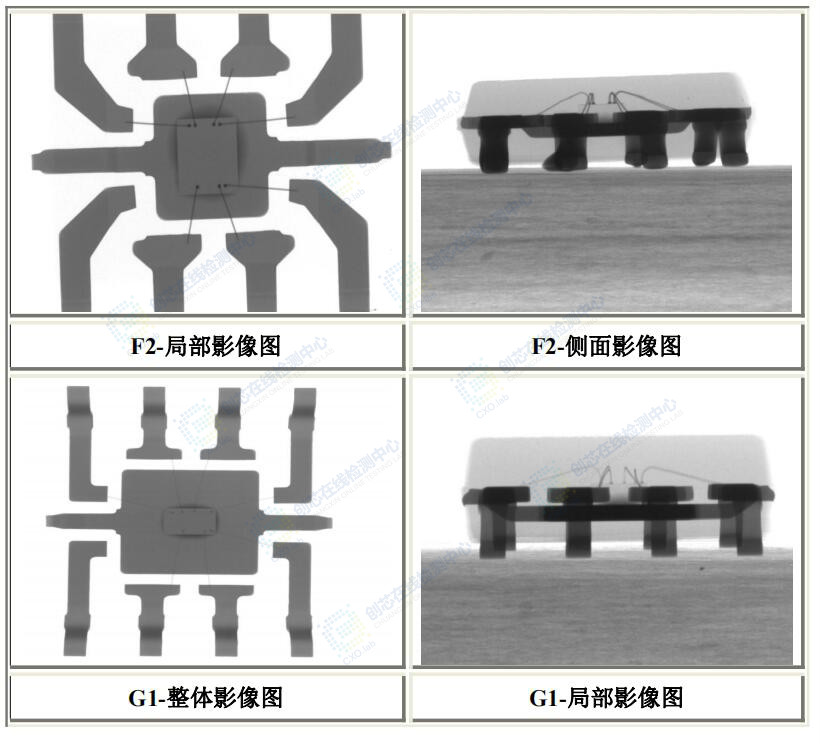
3. 综合分析及结果:
测试结果:
外观检查发现 F1 和 F2 失效样品均不符合 AMTEL 厂商丝印规则,对所有样品观察均未发现破损、断 脚等异常现象。 对 F1,F2 与 G1 样品对比测试,结果如下: 框架结构不同的样品:F1,F2&G1 Die 不同的样品:F1&F2, F1&G1, F2&G1 键合线材质疑似不同的样品:F1,F2&G1 电特性测试分析验证 F2 样品清空不为空,无法重新烧录。
产品故障失效原因:
由于外观和 X-ray 检查结果均发现与 G1 样品不同的丝印规则与封装设计,因此根据应用端描述与综 上测试结果分析认为器件整机测试不良可能是由于不同厂商设计的器件驱动能力不同造成。
改善建议
1.更换符合设计电路的器件使用;
2.建议原厂对不良批次物料进行多次封装可靠性验证,排除封装隐患;












